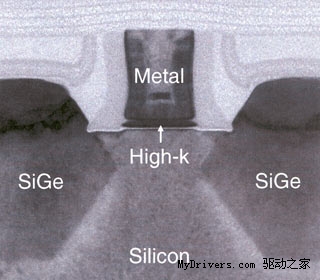 日本尔必达今天宣布,将在40nm级别DRAM内存制造工艺上首次引入高K金属栅极(HKMG)技术,用于开发2Gb DDR2 Mobile DRAM(LPDDR2)移动内存颗粒。
日本尔必达今天宣布,将在40nm级别DRAM内存制造工艺上首次引入高K金属栅极(HKMG)技术,用于开发2Gb DDR2 Mobile DRAM(LPDDR2)移动内存颗粒。HKMG这一技术最早出现在Intel 45nm工艺上,台积电、GlobalFoundries等也都正在纷纷将其应用在自己的产品线上。它在晶体管栅极上使用了高介电常数的绝缘膜,用以降低漏电率、提升晶体管性能,同时还需要是金属栅极电极作为配合。
HKMG技术正在处理器制造上广泛普及,但是因为高K金属栅极形成后热处理温度太高,而且DRAM内存的结构特性更加复杂,一直无法将其导入DRAM制造工艺。
经过努力,尔必达最终成功降低了热处理温度,并克服了DRAM结构的复杂性难题。相比于传统的二氧化硅电介质,HKMG技术能够在新的DDR2 Mobile RAM颗粒中将晶体管内栅极电介质的电气厚度减少大约30%,同时将晶体管开启时的电流增加最多1.7倍,关闭时候的电流降低至目前的百分之一,从而大大提升性能,并明显减少待机状态时的功耗。
尔必达计划在自己主营的Mobile DRAM移动内存颗粒产品线中全面应用HKMG技术,并继续评估和改进HKMG技术,争取今后用在30nm、25nm工艺上。
尔必达的40nm+HKMG Mobile DRAM内存颗粒将于今年年内试产,随后投入量产。

 固态硬盘?希捷更看
固态硬盘?希捷更看
